金属直接键合
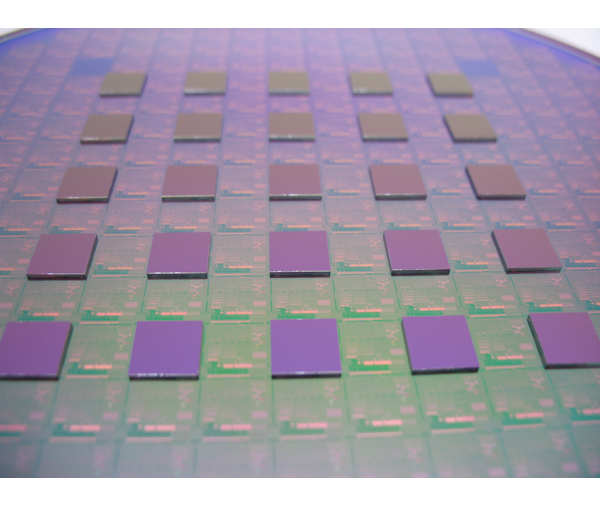
工艺制程
直接/混合键合用于组装两个芯片之间的组装,具有三个主要优点:
- 较低的键合压力
- 可以在室温下实现键合
- 较短的工艺时间
但是,该工艺也对键合过程提出了一个即为苛刻的要求:键合芯片必须具备极其洁净的表面。
技术优势
该键合工艺过程在低压力和室温下实现,从而可以避免不同材料在键合过程中的热膨胀,最终实现高密度、高精度互连。
为了确保无孔洞键合,对准和键合步骤必须在无尘环境中进行。 这是通过在设备中使用特殊材料并仔细管理设备内部气流来实现的。
所有这些技术优势确保可以实现各类型3D集成工艺所需的高运行速度。
长久丰富的技术经验


2009年,SET公司参与了与CEA-Leti, ST-Microelectronics, ALES和 CEMES-CNRS的合作项目 PROCEED,该项目由Minalogic和法国政府支持。
在该项目中,SET成功验证了芯片–晶圆之间实现直接/混合键合的可行性,在一个经过特殊设计的FC300上,实现了< 1μm的键合结果。这一成功结果在多篇相关论文中均有提及。
2015年末,SET公司正式加入了IRT NANOELEC项目,目标是设计一款专用于直接/混合键合的高速-高精度倒装焊机,在PROCEED项目的基础上,SET公司设计了NEO HB,用于直接/混合键合工艺的批量生产。
2019年,SET公司在SEMICON Taiwan正式发布了NEO HB,满足了3D集成工艺对高运行速度的需求。

 en
en fr
fr de
de zh
zh